随着AI芯片、5G通信设备对封装密度和可靠性的要求突破传统极限,FCP(Flip Chip Package)倒装芯片技术已成为中半导体的核心封装方案。然而,高密度焊点(最小间距达80μm)与复杂基板堆叠结构,使得封装体在潮湿、盐雾、硫化等恶劣环境中面临严峻挑战。
东莞路登科技推出的FCP通用三防治具,专为倒装芯片封装设计,通过材料创新与工艺适配,实现防护性能与生产效能的平衡。
一、技术痛点与解决方案
焊点脆弱性:倒装芯片的锡球/铜凸点直接暴露于环境,传统三防漆易导致焊点应力集中。本治具采用纳米改性有机硅树脂,CTE(热膨胀系数)与基板匹配度提升40%,经2000次温度循环测试无开裂。
高精度涂覆需求:针对65×65mm大尺寸封装,配备微米级点胶阀与视觉定位系统,实现±25μm的涂覆精度,避免焊桥短路。
工艺兼容性:支持回流焊后直接涂覆,适配FCBGA、FCCSP等主流封装形式,良率提升至99.2%。
二、核心竞争优势
材料突破:开发的低介电常数(Dk<3.5)防护层,减少信号传输损耗,满足7nm芯片的高频需求。
成本优化:单次涂覆覆盖率达98%,较传统工艺节省30%材料消耗。
环保认证:通过RoHS与REACH标准,无铅配方符合汽车电子AEC-Q100要求。
三、典型应用场景
数据中心HPC芯片:解决多芯片堆叠导致的局部过热问题,导热系数达1.8W/m·K。
车规级功率器件:通过ISO 16750-4盐雾测试,防护寿命延长至15年。
可穿戴设备:超薄涂覆层(厚度≤15μm)适配100μm超薄芯片封装。
四、客户价值
可靠性提升:三防后产品失效率降低至50ppm,MTTF(平均无故障时间)提升3倍。
生产增效:模块化设计支持快速换型,单线日产能达2000片。
定制服务:提供DOE实验与材料验证,满足客户差异化需求。
FCP倒装芯片封装通用三防治具:高密度互联时代的可靠性解决方案

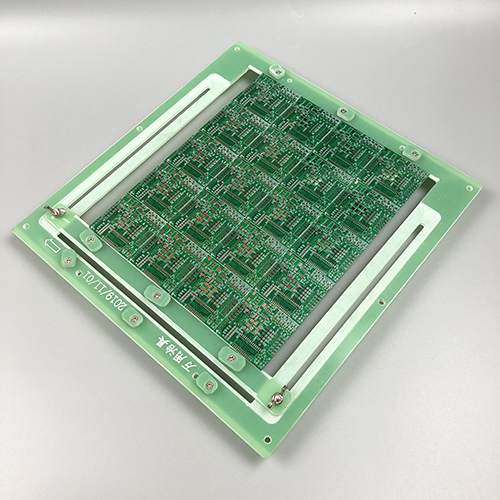
10
07
2025
FCP倒装芯片封装通用三防治具通信电源板贴胶治具 FCP倒装治具 芯片封装治具
来源:[东莞市路登电子科技有限公司]
联系人:方先生
手机:13829293701
电话:-
传真:-
QQ:355355700
Email:
地址:地区
品牌:路登
价格:98.00
元/件
供应地:
产品型号:FCP倒装芯片封装通用三防治具

